倒装芯片底部填充
工典科技
工典科技
底部填充是对倒装芯片下部的填充保护。灌封保护倒装芯片不受外界损坏(保持芯片与外界环境的隔离)。密封倒装芯片底部芯片。将倒装芯片固定在PCB或基板上。实现机械定位
非接触喷射点胶技术是在电路板上对芯片级封装 (CSP)、球栅阵列 (BGA) 和层叠封装 (PoP) 进行底部填充的最佳方法。
图片
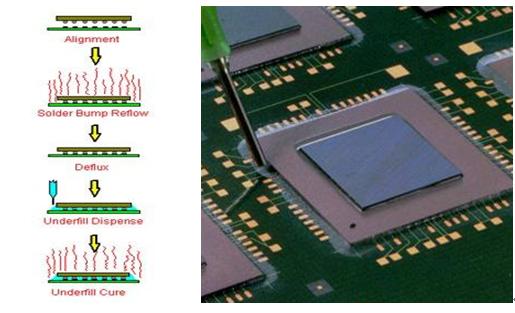
应用简述
EPOTEK产品
可毛细渗透的粘度,流动性的VS不流动的
填料的问题:硅微粉用做低CTE,BN用于高导热,无填料的用于光学透明
固化条件和终端市场的使用条件(手表业的底部填充VS助听器和起搏器的底部填充)
流动性的 | 非流动性的 |
U300-2 | 353ND-T |
301-2 | OE138 |
301-2FL | OG116-31 |
OE121 | |
353ND | |
330 |
晶圆级的底部填充是丝网印刷或旋转流涂到晶圆活性表面将底部填充料B阶凝胶将晶圆切割成单个晶片,将晶圆倒装到基板上,定位固化。
EPOTEK产品:
B9021-6 |
B9021-1 |


